致力于高功率密度碳化硅模块的研发与生产,「利普思半导体」获得 4000 万元
扫一扫
分享文章到微信

扫一扫
关注99科技网微信公众号
原标题:致力于高功率密度碳化硅模块的研发与生产,「利普思半导体」获得 4000 万元 Pre-A 轮融资
获悉,无锡利普思半导体有限公司(简称利普思半导体)近日完成 Pre-A 轮融资,由正泰集团领投、水木易德跟投,融资金额达 4000 万元。利普思半导体成立于 2019 年 11 月,从事功率半导体模块的封装设计、生产和销售。公司主要产品是应用于新能源汽车、充电桩、工业电机驱动、光伏逆变、医疗器械等场景的 IGBT 模块和 SiC 模块。
本轮融资后,利普思半导体将进一步增强技术和产品研发力度,加大市场推广力度,早日实现 IGBT 模块和碳化硅(SiC)模块的大批量生产。
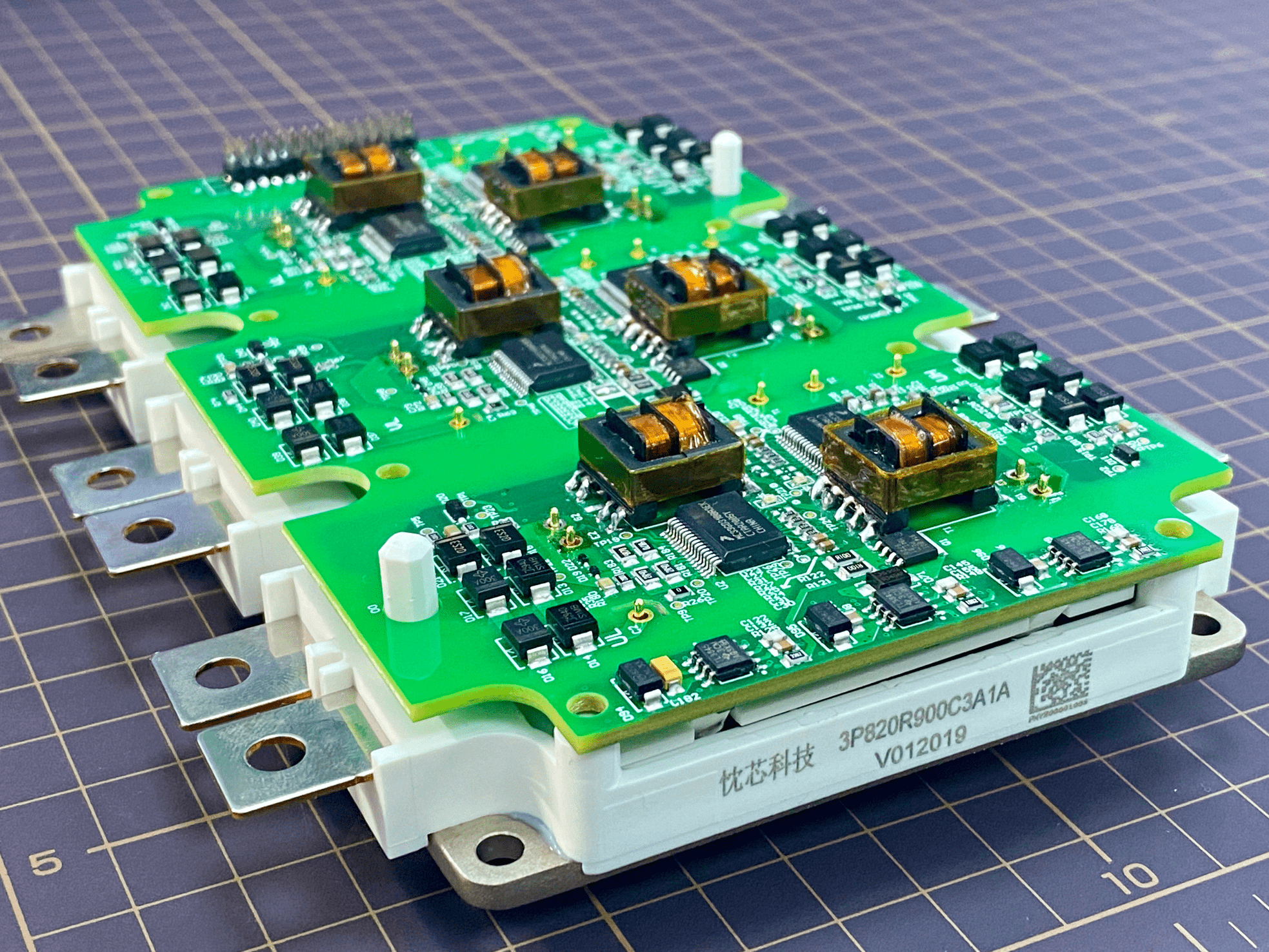
半导体行业产业链主要包括设计、制造、封装测试及下游应用等环节。利普思半导体从事的半导体模块封装在产业链中占据重要地位,主要任务是将芯片封装在模块内,为芯片提供稳定可靠的工作环境,并提供芯片和应用系统之间的电、热与机械的互联。据中商产业研究院的数据,2019 年我国半导体封装测试的产业规模为为 2494.5 亿元,2020 年的产业规模将达到 2841.2 亿元。
进行技术创新,提升半导体模块功率
利普思半导体创始人梁小广表示,功率模块要面对高电压、高发热与各种苛刻的工作环境,产品结合了功率半导体、电气、机械、材料、热学、流体等多方面的学科,难度非常高。第三代半导体尤其是碳化硅(SiC)需要工作在更高的温度,更大的电流密度,芯片散热面积也只有 IGBT 的 1/4 以下,给散热、可靠性与机械连接设计带来极大的挑战。
截至 2020 年 9 月,公司已获得多项发明专利,在提升模块电流能力和功率密度方面进行了多项技术创新。碳化硅芯片的表面连接采用全新的自主芯片连接专利技术(Arcbonding),可以在一个较小体积的碳化硅模块里边封装入多达 20 个碳化硅芯片。目前特斯拉使用的碳化硅模块只实现了 2 个碳化硅芯片的在一个碳化硅模块的封装。这一技术极大提高了模块的功率密度和可靠性,还进一步降低导通电阻和寄生电感。
利普思在系统散热方面也有自己的 Know-how,实现了芯片到散热基板、基板到水冷系统的全银烧结结合,以及更合理的水流散热结构设计。满足了汽车厂商对水冷散热中的冷却液压力损失的最小化。
据悉,利普思半导体总部位于无锡,已经在日本建立了研发中心,目前初具规模。团队成员平均半导体从业时间为 20 年,曾就职于三菱、东芝、三洋、日立等公司。未来团队人员还会继续扩充。
99科技网:http://www.99it.com.cn















